اتصالات میان سیلیکونی AMD تراکم اتصالات را ۱۵ برابر افزایش میدهند

تکنولوژی پشتهسازی سهبعدی در تراشهها هنوز آنطور که باید، در دنیای سختافزار جا نیفتاده است و نوعی از این تکنیک را در تکنولوژی Intel Foveros که قرار است روی پردازندههای Lakefield اینتل مورد استفاده قرار بگیرد و همچنین برخی از پردازندههای مبتنی بر ریزمعماری Zen 3 شرکت AMD با پشته کش عمودی، خواهیم دید.
اما به نظر میرسد AMD توجه خود را بیشتر به سمت استفاده از این تکنولوژی معطوف کرده و در سمپوزیوم Hot Chips امسال نیز از برنامههای بلندپروازانه خود در این حوزه سخن گفته است.
AMD در کامپیوتکس امسال از وی-کشهای سهبعدی خود صحبت کرده بود که با افزودن کشهای L3 به پردازنده Ryzen 9 5900X به وجود آمدهاند و کارایی را در بازیها حدود ۱۵ درصد افزایش میدهند. چنین حالتی از پشتهسازی سهبعدی به AMD این امکان را میدهد تا با استفاده از فرایند ساخت مناسب، SRAM را بهصورت متراکمتر روی بخش بالایی دای (Die) قرار داده و بنابراین، ۶۴ مگابایت را بهصورت مستقیم روی ۳۲ مگابایتِ دای اصلی جای بدهد.
این روند در واقع به لطف استفاده از TSV ممکن میشود که در آن اتصالات مس به مس بهصورت مستقیم و عمودی استفاده میشوند و نسبت به تکنولوژیهای متداول میکروبامپ، فاصله اتصالات بسیار کمتر است و بنابراین میتوان اتصالات بیشتری را در فضای متراکمتر جای داد.
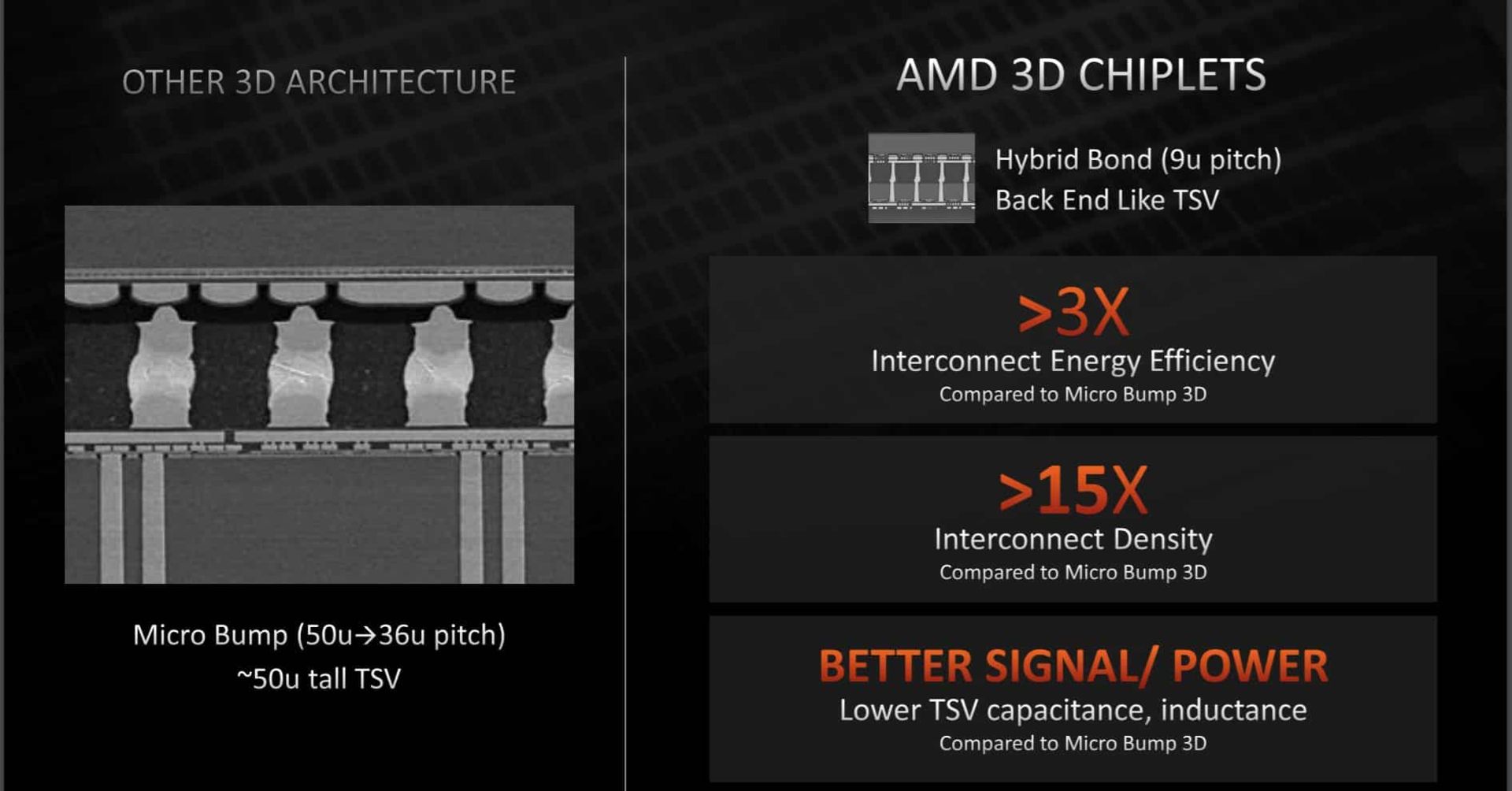
AMD ادعا کرده است که تکنولوژی اتصال مستقیم هیبریدی این شرکت، فاصله بین اتصالات را به ۹ میکرومتر میرساند. برای مقایسه، اینتل در تکنولوژی Intel Foveros بهکاررفته در پردازندههای Lakefield به فاصله ۵۰ میکرومتر دست یافته است. به نظر میرسد AMD با همین مقایسه توانسته است بهبود ۳ برابری در بهرهوری و تراکم ۱۵ برابری اتصالات را گزارش کند.
از سوی دیگر، اینتل در تکنولوژی دیگر خود یعنی Foveros Omni فاصله اتصالات ۳۶ میکرومتر را گزارش کرده است. این تکنولوژی قرار است در پردازندههای Meteor Lake به کار برود. علاوه بر این، فاصله اتصالات ۱۰ میکرومتر نیز برای تکنولوژی Foveros Direct اینتل گزارش شده که قرار است یک راه حل هیبریدی باشد و به نظر میتواند در زمینه تراکم اتصالات با تکنولوژی جدید AMD رقابت کند.
اما هردو تکنولوژی هیبریدی اینتل و AMD، برای سال ۲۰۲۳ برنامهریزی شدهاند. این در حالی است که تراشههای رایزن AMD با بهرهگیری از پشتهسازی سهبعدی، تا پایان سال جاری میلادی به تولید انبوه خواهند رسید.
AMD همچنین با TSMC روی طراحیهای پیچیدهتری از پشتهسازی سهبعدی کار میکند تا بتواند ایده جاهطلبانه پشته کردن پردازندهها روی یکدیگر را پیادهسازی کند. در این صورت، ماکروبلاکهای پردازنده (مثل لایههای پایینتر کش) بین لایههای مختلف تقسیم میشود یا حتی ممکن است این روند تقسیمبندی، به سطح برش مدار نیز برسد.

پشتهسازی بخشهای پردازشی، چالشهای بزرگی پیش روی طراحان قرار میدهد؛ مثلا رساندن توان به دایهای بالاتر یا خنکسازی دایهای پایین پشته میتواند بخشی از این مشکلات باشد. در واقع به دلیل همین موارد است که وی-کش سهبعدی AMD در بالای کش دای اصلی مستقر میشود و هستههای پردازشی در این بین نقشی ندارند.
البته، پیادهسازی تمام این برنامهها وابستگی مستقیمی به بهبودهای آتی در زمینه توان، عملکرد، سطح اشغالشده تراشهها و هزینه خواهد داشت.
به نظر شما آیا ممکن است طی سالهای آتی شاهد استفاده بیشتر از تکنولوژی پشتهسازی، حتی در بحث پردازندهها باشیم؟ در این صورت افزایش توان پردازشی و بهبود عملکرد پردازندههای چندلایه را چگونه ارزیابی میکنید؟

برای بسیاری از کاربران دوربین گوشی مهمترین بخش آن محسوب میشود؛ اما کدامیک از مدلهای شیائومی بهترین دوربین را در بازههای قیمتی مختلف دارند؟

در مقالهی پیش رو، با بهترین پاور بانک بازار ایران برای گوشی اندروید و آیفون از برندهایی مانند انکر، راوپاور، باسئوس و مک دودو آشنا میشویم.

اگر بهدنبال گوشی هوشمند برای بازی میگردید، نیاز نیست حساب بانکیتان را خالی کنید. در این مقاله بهترین گوشیهای گیمینگ بازار ایران را معرفی ...

اگر نگران گمشدن یا سرقت گوشی هستید، این راهنما روشهای مؤثر ردیابی گوشی گم شده و جلوگیری از سوءاستفاده را بهصورت کامل به شما معرفی میکند.

اگر میخواهید بدانید که چطور میتوانید انواع تراکنشهای بانکی خود را پیگیری کنید، تا انتهای این مطلب همراه زومیت باشید.

کاربران برای ورود به دنیای رمزارزها، نیاز به فعالیت در صرافیها دارند. در این مقاله بهترین صرافیهای ارز دیجیتال برای ایرانیان را معرفی خواهیم کرد.
-638bb8678b369136d458d530?w=1920&q=75)
بهترین آیفون کدام مدل است؟ آیا با هر بودجهای میتوان آیفون خرید؟ با معرفی بهترین آیفون در هر بازهی قیمتی همراه زومیت باشید.





